Dicing
We propose dicing with the optimum construction method from the viewpoint of both quality and cost.
Blade dicing
- Various blades and processing conditions are prepared and it is possible to handle from a wide scribe width (150um) to a narrow scribe width (40um).
- Dicing experience with thin wafer (t70um).
- Owns the condition to suppress corrosion of aluminum pad.
- Corresponding size : 4inch - 12inch.
BG is also available. Click here for BG processing
Stealth laser dicing
- Technology that locally performs laser processing inside the material and divides the substrate by expansion.
- Since it is not necessary to use water like blade dicing, stealth laser dicing, which is a dry process, is effective for wafers with fragile structures such as device using thin film.
- Compared to blade dicing, backside chipping is extremely small, making effective use of the back side possible.
- Corresponding size : small piece - 8inch.

Water jet laser dicing
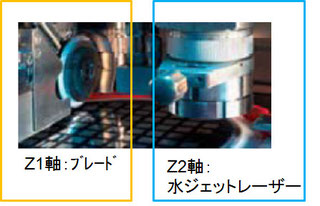
- It is a hybrid processing equipment combining blade, water jet, laser.
- Since the laser beam is reflected within the water jet and irradiated to the work, there is no need for focusing.
- Ideal for wafer dicing with back metal.
- Corresponding size : 4 - 8inch.
Performance
- SiC, alumina (purity : 99.5% or less), silicon nitride
- LED wafer
- Back metal wafer (Al-Si) (Ni-Si) (Cu) etc.
For details about water jet laser dicing, please click here











