CMP加工
CMP(Chemical Mechanical Polishing ―化学的機械研磨―)は多層配線基板の作製に欠かせない技術です。
このページではCMPの適用範囲を、加工事例を交えて紹介します。
CMP
・2インチ~12インチ対応可能
・角型基板、小片基板にも対応可能
・アプリケーションに合わせたスラリーの選択が可能
・ガラス、セラミック基板等の研磨も可能
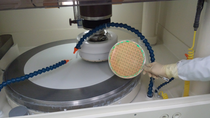
こんな時にご活用ください
・満足な研磨速度が得られない
・スクラッチが多い、プロセスマージンが狭い
・選択比が欲しい
・既存のCMPスラリーにご不満をお持ちの方
・パッドやスラリーの評価がしたい方
・試作開発等、小ロットでの加工がしたい方

特色
・お客様のご要望、アプリケーション、そして加工条件に合わせた
製品開発を行います。
・豊富なラインナップから研磨対象と加工プロセスに合致したスラリー
及びパッドを選定し加工いたします。
・加工時の回転数、圧力の微調整も可能です。

弊社CMP装置の加工の一例になります
CMPの目的
多層配線の層数が増えるに伴いIC表面の凸凹が増え段差が大きくなります。
大きくなった段差は成膜、レジスト形成の際に支障をきたし微細パターン形成を困難にします。
そのため凹凸を平坦化するCMPは加工を円滑にし、より多層な配線を作製するのに必須な技術になります。
また、下記の目的でもCMPが活用されます。
・基板同士の貼り合わせの際の基板表面の平坦化
・鏡面加工-基板の表面粗さの低減
・スクラッチやパーティクル等の表面欠陥の低減
CMPの用途
層間絶縁膜の平坦化


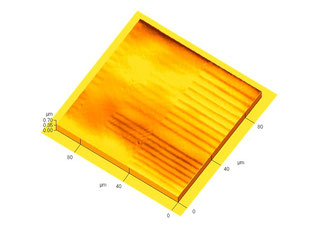
ダマシンプロセス


TSV
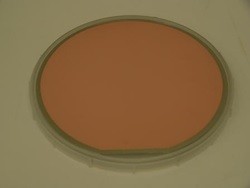



接合前の表面粗さ向上