CMPについて
CMP(Chemical Mechanical Planarization ―化学的機械的研磨による平坦化技術―)は多層配線基板の作製に欠かせない技術です。このページではCMPの適用範囲を、加工事例を交えて紹介します。
CMPの目的
多層配線の層数が増えるに伴い、IC表面の凸凹が増え、段差が大きくなります。大きくなった段差は成膜時の膜厚、露光時の焦点が合わなくなったり、微細パターンの形成が困難になってきます。
そこで表面の平坦化技術として必須なのがCMPです。
CMPの用途
層間絶縁膜の平坦化


ダマシンプロセス

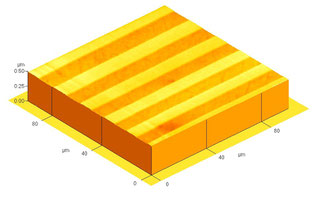
TSV



接合前の表面粗さ向上